TSV - lepsze połączenia między chipami
IBM ma zamiar na masową skalę wykorzystywać nową technologię łączenia układów scalonych i ich części. Dzięki temu Błękitny Gigant chce poprawić ich wydajność i jednocześnie zmniejszyć pobór mocy.
Technologia TSV (through-silicon vias) pozwala na łączenie zarówno procesora i pamięci, jak i rdzeni procesora ze sobą. Połączenie jest realizowane przez tysiące niewielkich przewodów, którymi wędrują dane. Obecnie zadania te spoczywają na urządzeniach zwanych szynami, które jednak często ulegają przeciążeniu. TSV pozwala na przesłanie większej ilości danych w ciągu sekundy, a pobór mocy jest przy tym niższy niż w przypadku szyn.
IBM nie jest pierwszą firmą, która chce wykorzystać TSV. Wspominał już o tym Intel przy okazji swojego 80-rdzeniowego procesora. IBM ma natomiast zamiar zastosować nową technologię na masową skalę. Pierwsze próbki układów z TSV trafią do klientów jeszcze w bieżącym roku, a w 2008 zacznie się ich masowa produkcja.
IBM ocenia, że w układach wykonanych z krzemu domieszkowanego germanem (tzw. rozciągnięty krzem) uda się zaoszczędzić nawet 40% energii.
W układach z technologią TSV zostaną nawiercone mikroskopijne otwory, przez które zostanie przeciągnięte okablowanie z wolframu.
Badacze IBM-a mają nadzieję, że w ciągu 3-5 lat dzięki TSV uda się połączyć pamięć bezpośrednio z procesorem, bez konieczności stosowania kontrolera pamięci. Powinno to zwiększyć wydajność o dalsze 10%, a pobór mocy zmniejszyć o 20%. Błękitny Gigant pokłada tak wielką nadzieję w nowej technologii, że planuje zastosowanie jest w swoich superkomputerach BlueGene.
TSV pozwoli też na zmianę architektury płyt głównych. Obecnie niektóre firmy budują je w ten sposób, że łączą układają kości jedną na drugiej. Pozwala to zaoszczędzić miejsca, ale układy łączą się ze sobą za pośrednictwem szyn, więc nie ma zysku wydajności. TSV pozwoli pozbyć się szyn, a tym samym zwiększyć wydajność. Ponadto, dzięki likwidacji szyn możliwe będą dalsze oszczędności miejsca (układy będą połączone za pomocą poprowadzonych w środku kabli).
Rozpowszechnienie się TSV doprowadzić może do zmiany sposobu sprzedaży układów producentom płyt głównych. Będą oni mogli kupić od takich firm jak IBM czy Intel gotowe połączone ze sobą zestawy, składające się z procesora, chipsetu i pamięci. To jedna z możliwych metod zwiększenia wydajności systemów komputerowych.
Wśród innych warto wymienić technologię produkcji trójwymiarowych układów pamięci opracowaną przez Matrix Semiconductor czy technologię rozwijaną przez Sun Microsystems, która umożliwia przesyłanie danych pomiędzy odpowiednio blisko znajdującymi się układami. Interesująca jest również technologia Loki, firmy Rambus, która zapewnia przesył danych z prędkością 6,25 gigabita na sekundę przy poborze mocy rzędu 2,2 miliwata na gigabit.
Niedawno Rambus pokazał prototypowy system Loki, który przez 40 godzin był w stanie pracować na dwóch bateriach AA i przesłał w tym czasie 3,6 petabita (3,6 miliona gigabitów) danych.
Wracając do TSV warto wspomnieć, że Intel rozwija tą technologię od 2005 roku. Firma nie jest jednak jeszcze gotowa do jej wykorzystania na masową skalę. Inżynierowie Intela chcą użyć TSV do połączenia w jednej obudowie procesora i pamięci operacyjnej, to jednak rodzi poważne kłopoty związane z wydzielaniem ciepła.
Wszystko więc wskazuje na to, że na rynek TSV trafi po raz pierwszy dzięki IBM-owi.

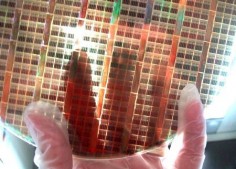

Komentarze (0)