Jest przyszłość przed litografią w ekstremalnie dalekim ultrafiolecie?
W czasie dwóch osobnych wystąpień na konferencji SPIE Lithography, przedstawiciele Intela i TSMC ożywili oczekiwania na rozwój litografii w ekstremalnie dalekim ultrafiolecie (EUV). Z technologią tą od dawna łączy się wielkie nadzieje. Ma ona pozwolić na produkcję coraz mniejszych elementów elektronicznych. Jednak od dłuższego już czasu trudno optymistycznie patrzeć na przyszłość EUV. Wcześniej związany z nią entuzjazm był tak olbrzymi, że prognozowano, iż przemysł będzie korzystał z litografii w ekstremalnie dalekim ultrafiolecie już od 2007 roku. Dotychczas jednak technologia ta nie została wdrożona.
Teraz Intel i TSMC twierdzą, że około roku 2017 dzięki EUV będą produkowały 10- i 7-nanometrowe układy scalone. Mark C. Philips, odpowiedzialny w Intelu za litografię, mówi, że produkcja układów scalonych staje się walką o każdy nanometr, której nie można prowadzić bez rygorystycznych, popartych matematyką badań. Zdradził przy okazji, że holenderski ASML, największy na świecie producent urządzeń do litografii, opracował nowe narzędzie analityczne pozwalające wyłapywać błędy w układach scalonych przyszłości. Aby objaśnić jeden tylko problem rozwiązywany przez nowe narzędzie trzeba by zapisać wzorami około 10 stron, stwierdził Philips. Nowe narzędzie będzie kluczem do wykorzystania tzw. litografii komplementarnej, która łączy współczesną litografię zanurzeniową z EUV.
O tym, jak wielkie znaczenie dla przemysłu IT mają prace podjęte przez ASML niech świadczy fakt, że w 2012 roku Intel zainwestował w tę firmę 4 miliardy dolarów, a TSMC miliard USD. Pieniądze te mają posunąć badania naprzód.
Obecnie przed litografią EUV stoją dwa główne problemy. Pierwszym jest konieczność opracowania źródła zasilania dla maszyny naświetlającej około 200 plastrów krzemowych na godzinę. Osiągnięcie takiej wydajności jest konieczne, by cały proces był ekonomicznie uzasadniony. Inżynierowie marzą o 250-watowym źródle. Na razie udało się zaprezentować 10-watowe źródła pracujące przez 20% czasu działania maszyny. Mają nadzieję, że wkrótce opracują źródło 30-watowe, zdolne do ciągłej pracy. Początkowo planowano, że informacje o takim źródle zostaną zaprezentowane podczas SPIE Lithography, jednak inżynierowie popełnili błąd podczas podłączania 200-kilowatowego lasera i doszło do uszkodzenia maszyny litograficznej.
Drugi problem to eliminacja błędów w maskach wykorzystywanych przy EUV. ASLM powołało nowy zespół roboczy, który zajmuje się tylko i wyłącznie udoskonaleniem masek. Firma nawiązała w tym celu współpracę z innym holenderskim przedsiębiorstwem – Philipsem..


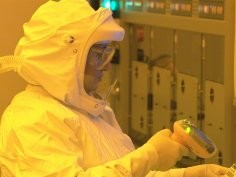

Komentarze (3)
Astroboy, 27 lutego 2014, 18:27
No i co z tego wynika? Zarządzają tam przedszkolacy?
10 stron wzorów dla matematyka czy fizyka to lektura do kawy. Zwykle lekka.
No i to jest argument. Z posuwaniem byłbym ostrożniejszy.
Myślę, że to podstawowy problem. Cóż, daleki ultrafiolet jest dość przenikliwy.
mjmartino, 28 lutego 2014, 08:23
Pewnie jak zainwestowali to i by chcieli tą kasę odzyskać... więc albo nowy gracz na rynku zajmie się grafenem albo poczekamy aż potentaci wsysają z nas każdą złotówkę a potem będzie bum
Z reszta już teraz INTEL opóźnij wydanie 14nm na koniec tego roku.. wiec układy 10 czy 7nm dopiero 2020 nie wcześniej.
Poza tym trend nastawiony jest na Mobile
pogo, 28 lutego 2014, 11:13
Ja wciąż wierzę, że ten trend na mobile jest tylko tymczasowy.
Ale nawet mobile potrzebuje mniejszych technologii tranzystorów.
A nad grafenem muszą pracować, bo te 10 czy 7 nm też nie będzie technologią wieczną. W grafenie braków jest dużo, więc i trzeba dużo czasu na ich uzupełnienie. Intel czy TSCM nie mogą sobie pozwolić na wypadnięcie z rynku gdy tylko wejdzie ta technologia (chyba, że mają zamiar zwyczajnie wydać kasę na licencjonowanie cudzych technologii, ale to wydaje mi się strzałem w kolano dla takich firm)